후공정 설비투자 1·2위 인텔·TSMC…4위 삼성
삼성, 패키징 시장 공략 위한 CEO 직속 TF 구축
두산, 테스나 인수 3개월 만 또 후공정 업체 실사
정부, 1.5조 투자…최초 후공정 연구센터 설립 예정

[한스경제=최정화 기자] 반도체 크기가 점점 작아지면서 회로를 미세화하는 작업이 한계에 다다랐다. 이같은 한계를 극복하기 위한 수단으로 글로벌 반도체업체들이 반도체 후공정(패키징·테스트) 사업에 주목하고 있다.
시장조사업체 욜디벨롭먼트에 따르면 올해 글로벌 첨단 패키징 시장 설비투자 규모는 미국 인텔(32%)과 대만 TSMC(27%)가 절반 이상을 차지한다. 이어 대만 ASE, 삼성전자 순이다.
인텔은 지난 2018년 포베로스라는 3D 패키징 브랜드를 선보인데 이어 2020년엔 이 기술을 반영한 레이크필드 칩을 개발해 삼성전자 노트북에 탑재했다. TSMC도 최근 미국 AMD 신제품을 3D 패키징 기술로 생산하기로 하고, 일본에 3D 패키징 연구센터를 만들어 지난달 24일부터 운영하고 있다.
삼성전자도 파운드리(반도체 위탁생산) 사업을 강화하기 위해 지난달 최고경영자(CEO) 직속 태스크포스(TF)를 만들어 패키징 시장 공략에 본격 나섰다. 경계현 삼성전자 DS부문장 사장은 올해 2월 열린 T&C 포럼에서 "향후 어드밴스드 패키징으로 반도체를 만들 것"이라며 "(패키징 사업은) 앞으로 집중해야 할 분야"라고 강조했다.
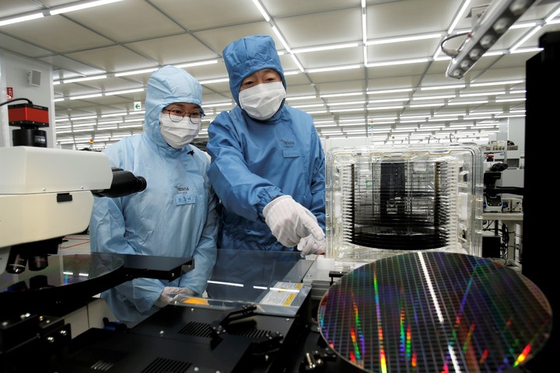
반도체 후공정 사업을 그룹 3대 신성장 동력으로 택한 두산은 테스나를 인수한지 3개월 만에 또다시 후공정업체 인수합병(M&A)에 착수했다.
업계에 따르면 두산은 후가공 업체 '엔지온'을 인수하기 위해 실사를 진행 중이다. 이번 M&A가 성사되면 두산은 반도체 웨이퍼·패키지 테스트부터 연삭·연마 공정까지 후공정 라인업을 확장하게 된다. 박정원 두산그룹 회장은 지난달 14일 두산테스나 사업장을 방문해 "향후 5년간 후공정 사업에 1조원을 투자하고, 5년 내 반도체 테스트 분야 글로벌 톱5로 성장하겠다"고 포부를 밝혔다.
이같이 후공정 사업에 대한 국내 기업의 관심은 증가하고 있지만, 아직 해외에 비하면 많이 부족한 상황이다. 더구나 후공정 분야 10위권 내 진입한 업체는 한 곳도 없다.
혁신적 한계에 부딪힌 반도체 미세화를 극복하기 위한 후공정 사업 확장에는 대기업과 중소기업 간 상생협력은 물론 정부의 지원이 절실하다.
이에 정부는 2030년까지 1조5000억원을 들여 국내 최초 후공정 연구개발(R&D)센터 설립을 추진하고, 후공정업계 육성 방안을 모색할 예정이다. 또 인천광역시는 송도국제도시와 남동국가산업단지에 '반도체 후공정 산업'을 중심으로 한 반도체 특화단지 조성을 추진 중이다.
최정화 기자 choijh@sporbiz.co.kr


